大家好,格姆特新材料的是专业研发制造电子胶黏剂的厂商,有着多年的丰富经验,今天我们就来共同分享一下关于底部填充胶(Underfill)中空洞的去除方法,希望能够帮助到大家。
大家好,格姆特新材料的是专业研发制造电子胶黏剂的厂商,有着多年的丰富经验,今天我们就来共同分享一下关于[底部填充胶](Underfill)中空洞的去除方法,希望能够帮助到大家。
在许多底部填充胶(underfill)的应用中,包括从柔性基板上的最小芯片到最大的BGA封装,底部填充胶(underfill)中出现空洞和气隙是很普遍的问题。这种在底部填充胶(underfill)部位出现空洞的后果与其封装设计和使用模式相关,典型的空洞会导致可靠性的下降,本文将探讨减少空洞问题的多种策略。
空洞检测。
如果已经确定了空洞产生的位置,你可能就已经有了检测空洞的方法,不同的方法对问题的解决都是有用的。其中最常用的三种检测空洞的方法分别是:利用玻璃芯片或基板,超声成像和制作芯片剖面或将芯片剥离的破坏性试验。
采用玻璃芯片或基板会十分有效,这种方法能对测试结果提供即时反馈,并且能有助于理解何种流动类型能使下底部填充胶(underfill)的流动速率达到最优化,而采用不同颜色的底部填充胶(underfill)材料也可帮助实现流动直观化。这种方法的缺点在于玻璃器件上底部填充胶(underfill)的流动和空洞的形成行与实际的器件相比可能有些细微的偏差。
超声声学成像是一种强有力的工具,它可以让使用者在底部填充胶(underfill)无论是否固化的情况下,检测实际产品器件存在于下底部填充胶(underfill)中的空洞。它的空洞尺寸的检测限制取决于封装的形式和所使用的仪器,所以与设备制造商进行联系来了解仪器能够检测到何种空洞尺寸是十分必要的。这类仪器在检测分层和互连失效的可靠性测试中也非常有用。
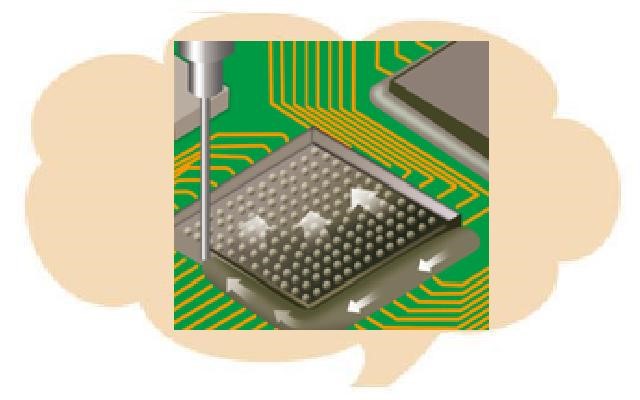
以上就是格姆特新材料小编收集底部填充胶(Underfill)中空洞的去除方法的相关知识,格姆特(苏州)新材料有限公司是专业研发生产各种UV光固化胶、热固化环氧胶、聚氨酯反应型热熔胶等电子粘胶剂,产品供应立讯精密、华为、苹果等国内外知名企业,如有关于电子粘胶剂的朋友可以咨询沟通,格姆特欢迎您的光临。本文部分信息/图片来源于互联网,仅供行业新资讯分享交流用途,勿作商用。如有涉权,请原著人第一时间告知我们,我们将立即删除,谢谢。以上就是在高温环境下关于粘胶剂的一些小知识啦,希望能给大家一些帮助!